
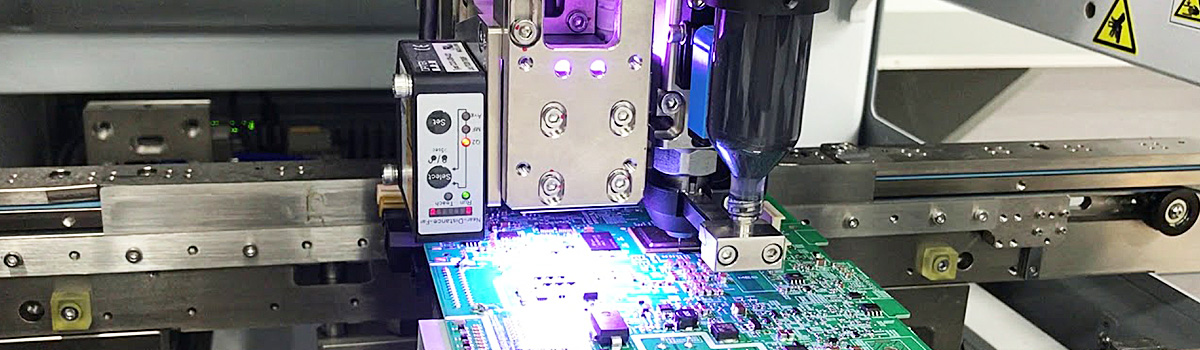
BGA Pakket Ondervulling Epoxy
Hoë vloeibaarheid
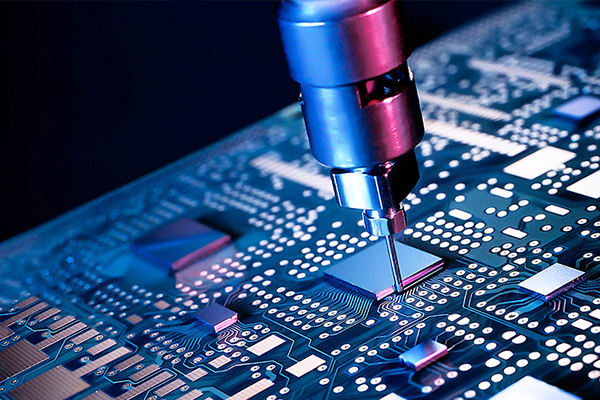
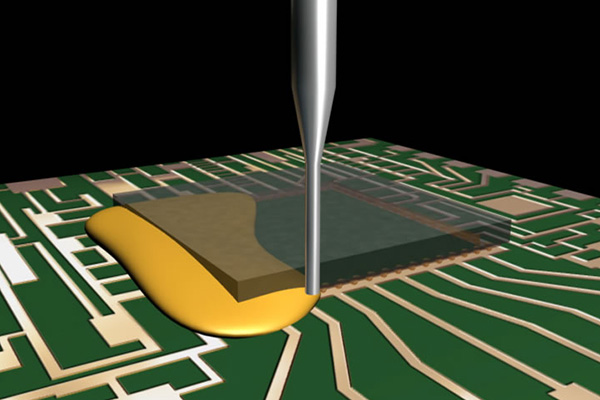
Hoë suiwerheid
Uitdagings
Elektroniese produkte van lugvaart en navigasie, motorvoertuie, motors, buite-LED-beligting, sonenergie en militêre ondernemings met hoë betroubaarheidsvereistes, soldeerbal-skikkingstoestelle (BGA/CSP/WLP/POP) en spesiale toestelle op stroombaanborde word almal gekonfronteer met mikro-elektronika. Die neiging van miniaturisering, en dun PCB's met 'n dikte van minder as 1.0 mm of buigsame hoëdigtheid-samestellingssubstrate, soldeerverbindings tussen toestelle en substrate word broos onder meganiese en termiese spanning.
Oplossings
Vir BGA-verpakking bied DeepMaterial 'n ondervulprosesoplossing - innoverende kapillêre vloei-ondervulling. Die vuller word versprei en op die rand van die saamgestelde toestel toegedien, en die "kapillêre effek" van die vloeistof word gebruik om die gom te laat penetreer en die onderkant van die skyfie te vul, en dan verhit om die vuller met die skyfiesubstraat te integreer, soldeerverbindings en PCB-substraat.
DeepMaterial ondervul proses voordele
1. Hoë vloeibaarheid, hoë suiwerheid, een-komponent, vinnige vulling en vinnige uithardingsvermoë van uiters fyn-pik komponente;
2. Dit kan 'n eenvormige en leemtevrye onderste vullaag vorm, wat die spanning wat deur die sweismateriaal veroorsaak word, kan uitskakel, die betroubaarheid en meganiese eienskappe van die komponente verbeter, en goeie beskerming bied vir produkte teen val, draai, vibrasie, vog , ens.
3. Die stelsel kan herstel word, en die stroombaan kan hergebruik word, wat grootliks koste bespaar.
Deepmaterial is lae temperatuur genesing bga flip chip ondervul pcb epoksie proses kleefmiddel gom materiaal vervaardiger en temperatuurbestande ondervul coating materiaal verskaffers, verskaf een komponent epoksie ondervul verbindings, epoksie ondervul omhulsel, ondervul inkapseling materiaal vir flip chip in pcb elektroniese stroombaanbord, epoksie- gebaseerde chip ondervulling en kop inkapseling materiaal en so aan.

