
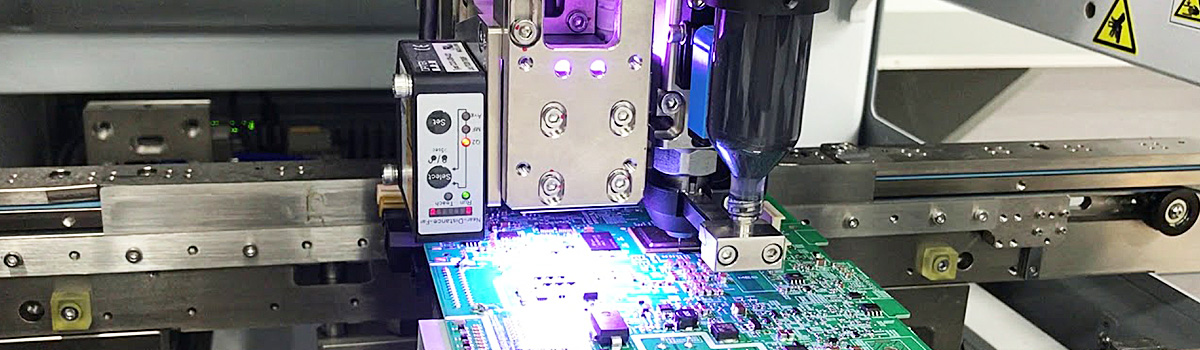
BGA Paketi Doldurma Epoksi
Yüksək axıcılıq
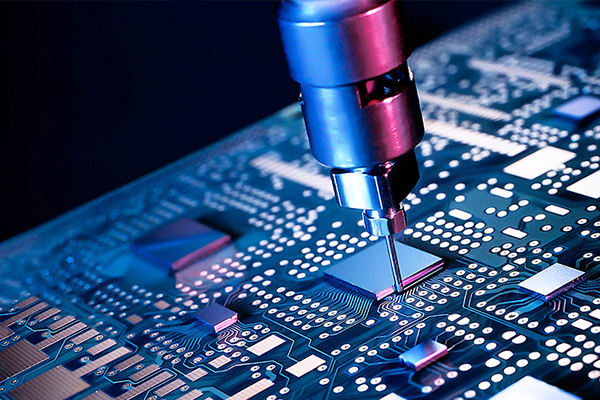
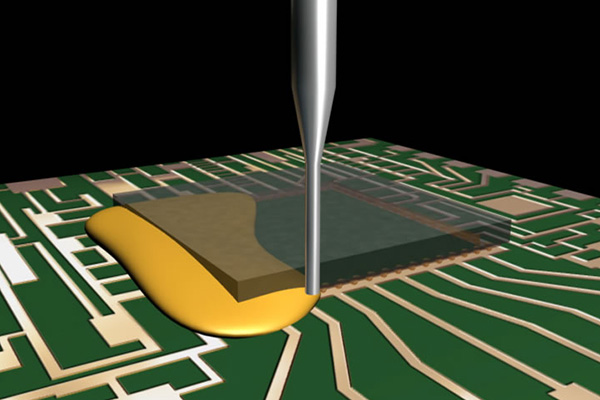
Yüksək təmizlik
Problemlər
Aerokosmik və naviqasiya, motorlu nəqliyyat vasitələri, avtomobillər, xarici LED işıqlandırma, günəş enerjisi və yüksək etibarlılıq tələbləri olan hərbi müəssisələrin elektron məhsulları, lehim topları sıra cihazları (BGA/CSP/WLP/POP) və dövrə lövhələrindəki xüsusi qurğular mikroelektronika ilə üz-üzədir. Miniatürləşmə tendensiyası və qalınlığı 1.0 mm-dən az olan nazik PCB-lər və ya çevik yüksək sıxlıqlı montaj substratları, cihazlar və substratlar arasında lehim birləşmələri mexaniki və istilik stressi altında kövrək olur.
Həllər
BGA qablaşdırma üçün DeepMaterial doldurma prosesinin həllini təmin edir - yenilikçi kapilyar axın doldurma. Doldurucu paylanır və yığılmış cihazın kənarına tətbiq olunur və mayenin "kapilyar effekti" yapışqanın nüfuz etməsi və çipin dibinə doldurulması üçün istifadə olunur, sonra doldurucuyu çip substratı ilə birləşdirmək üçün qızdırılır, lehim birləşmələri və PCB substratı.
DeepMaterial doldurma prosesinin üstünlükləri
1. Yüksək axıcılıq, yüksək təmizlik, birkomponentli, tez doldurulma və son dərəcə incə meydançalı komponentlərin tez bərkimə qabiliyyəti;
2. Qaynaq materialının yaratdığı gərginliyi aradan qaldıra, komponentlərin etibarlılığını və mexaniki xassələrini yaxşılaşdıra, məhsulların düşmə, bükülmə, vibrasiya, nəmdən yaxşı qorunmasını təmin edən vahid və boşluqsuz alt doldurma təbəqəsi təşkil edə bilər. və s.
3. Sistem təmir edilə bilər və dövrə lövhəsi yenidən istifadə edilə bilər ki, bu da xərcləri xeyli qənaət edir.
Dərin material aşağı temperaturda müalicəvi bga flip chip underfill pcb epoksi proses yapışqan yapışqan material istehsalçısı və temperatura davamlı dolgu materialı təchizatçılarıdır, bir komponentli epoksi dolgu birləşmələri, epoksi doldurucu kapsulant, pcb elektron lövhəsində flip çip üçün alt doldurma inkapsulyasiya materialları təmin edir, epox elektron dövrə lövhəsidir. əsaslı çip dolğusu və kob kapsülləmə materialları və s.

